
珠海越亚半导体股份有限公司(简称“珠海越亚”)成立于2006年4月26日,位于广东省珠海市斗门区富山工业区,厂房面积4万平方米。
珠海越亚是国内最早生产IC封装载板的陆资企业之一,是全球首批利用自主专利技术“铜柱增层法”实现“无芯”IC封装载板量产的企业,其生产的射频模块封装载板、高算力处理器IC封装载板、和系统级嵌埋封装模组在国内外相关细分市场均处于领先地位。
发展历程
2013年~至今快速发展阶段
2023年南通越亚二期启动筹建,珠海越芯进入大量产
2021年珠海越芯(三厂)启动筹建
2018年南通越亚(二厂)启动筹建,2021年FCBGA封装载板顺利量产
2017年嵌埋封装载板进入量产阶段
2014年嵌埋封装(Embedded Die)技术研发成功
2010年~2011年拓展阶段
2011年射频封装载板正式进入全球高端智能手机供应链
2010年成为世界首家实现无芯IC载板量产的企业
2006年~2007年初创阶段
2007年完成珠海越亚(一厂)厂房建设
2006年成立珠海越亚,在珠海多层的地下室诞生第一块IC载板
荣誉资质

主要产品
集成电路(IC)封装载板(IC substrate)是集成电路封装的核心部件,是半导体晶粒(Die)与各类被动器件(Passives)集成封装的直接载体,也是先进封装的关键材料。封装载板为半导体晶粒与各类被动器件提供电信互连、性能提升、固定支撑、散热和隔离保护的作用,亦可在载板内埋入半导体晶粒与被动器件以实现或增强系统级的功能,是实现集成电路封装薄型化、小型化、高密度和高性能的基础。
SiP封装载板
SiP(System in Package),是指在一个封装体内集成多颗半导体芯片和被动器件,从而实现系统级的电性功能的半导体模组,本公司将提供用以承载主、被动器件的高密度布局,并实现高频高速的电信互连和高散热的封装载板。
产品特性
1.5~12层,奇数或偶数层的超薄载板叠构
铜柱法支撑任意层和任意形状的高密度互联方式
任意层进行依序增层的加成法的载板工艺
铜柱互连的一致性提升射频信号的保真度,保证信号完整性
载板内置大面积电镀铜块极大地降低IR drop并提升电源完整性
堆叠铜块为芯片建立起高效散热的三维连接通道
可兼容采用传统的Tenting/MSAP技术
市场应用
手机/移动电话;宏基站;微基站;WiFi无线网络;AloT智能物联网(Cat1/Cat4);UWB超宽带
FCBGA封装载板
FCBGA(Flip-Chip Ball Grid Array),是一种将芯片以Flip Chip(倒装)的方式并通过金属凸点焊接于载板表面,并表贴被动器件一起封装成为一颗具有BGA(Ball Grid Array)或LGA(Land Grid Array)管脚的芯片。本公司将采用SAP(Semi-additive process)的顺序增层技术生产制造高密度高层数的FCBGA载板,实现倒装芯片的物理承载和高速传输的电信互连。
产品特性
4~16层以上实现对于先进制程芯片的高层数高密度的电信互连
采用uBall实现载板顶面预植数万颗微型锡球用于与芯片的金属凸点焊接
采用SAP带来顶层线路的高精度和高密度的线路能力
可形成BGA(Ball Grid Array)或LGA(Land Grid Array)的管脚类型
高精密度的镭射微孔和对位能力
市场应用
PC;服务器;数据中心;网络连接;AI;智能驾驶
嵌埋封装载板/模组
是指将芯片或者被动元器件嵌埋入封装载板的线路层间,并由载板的线路层将芯片或者器件的I/O扇出到外部管脚的一类新型封装方式,芯片嵌埋载板的顶面线路也可以用以承接其他芯片或被动元器件的功用,采用该工艺可以定制化的将主、被动元器件进行嵌埋封装形成新的系统级的封装器件或模组。
产品特性
嵌埋后可具有1~5层的扇出线路,并实现芯片顶底面互连的3D结构
具有自主知识产权的专利工艺并兼容传统MSAP技术带来更多的芯片与被动器件嵌埋集成
采用类晶圆工艺用核磁溅射薄膜钛铜金属(Sputter Ti/Cu)实现在芯片与载板的无缝连接
显著提升产品的电性能与散热效果,以及产品的长期可靠性
先进的设计规则带来比传统封装方式更加轻薄短小的封装尺寸
无需WB或Underfill的板级扇出型的方式带来更低制作成本
市场应用
宏基站;微基站;服务器;氮化镓快充;生物传感器
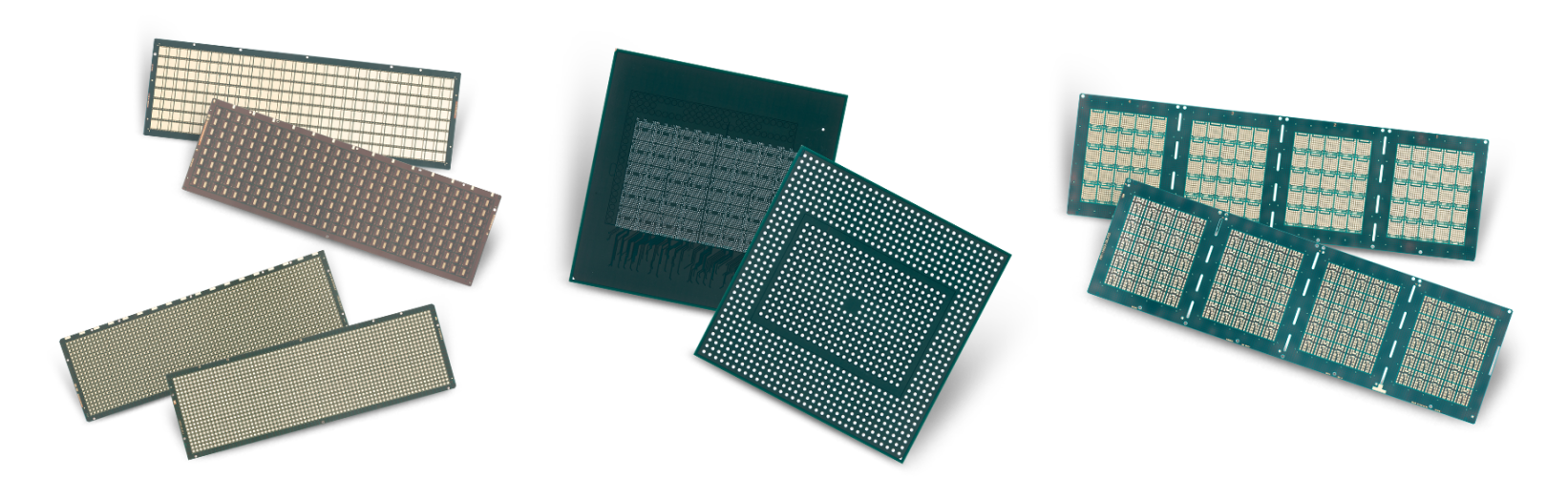
核心专利
Via-post 铜柱法专利技术
以电镀铜柱或铜块作为芯片散热的垂直通道;以电镀铜柱取代传统机钻镭钻为载板层间的互连方式;以电镀铜柱或铜块作为Cavity空腔的形成方法;以电镀铜柱或凸点作为芯片与载板的焊接点
Coreless 无芯封装载板专利技术
无需采用传统Core材;任意层起始的顺序增层工艺;基于铜柱法的任意层间的互连方式;基于铜柱法的任意形状的互连方式;实现超薄介质层堆叠的封装载板技术
主被动器件嵌埋封装专利技术
实现封装体三维尺度的缩小;同时内埋主被动组件于载板内形成系统级封装(SiP);利用铜柱技术导通芯片I/O及各层线路、高可靠性

分公司
珠海越亚半导体股份有限公司
南通越亚半导体有限公司
珠海越芯半导体有限公司
越亚封装基板(香港)有限公司
ACCESS Technologies USA(越亚美国)